
專屬客服號

微信訂閱號
全面提升數據價值
賦能業務提質增效
頭部企業紛紛入局
近一年來,封測領域頭部企業紛紛透露出布局玻璃基板的消息。
2023年9月,英特爾宣布將在2030年前推出用于下一代先進封裝的玻璃基板。并稱包括玻璃基板在內的先進封裝技術,將有助于英特爾實現2030年在單個封裝上集成一萬億個晶體管的目標。
英特爾稱,與目前采用的有機基板相比,玻璃具有超低平面度(flatness)、更好的熱穩定性和機械穩定性,由于這些獨特的性能,玻璃基板上的互連密度有望提升10倍。這意味著,采用該技術將支持在封裝中連接更多晶體管,并支持以更小的尺寸封裝更多的芯粒模塊,構建更大的芯片組(即“系統級封裝”)。
英特爾公司高級副總裁兼組裝與測試技術開發總經理Babak Sabi 稱,英特爾已經對玻璃基板技術進行了十余年的研究。據了解,英特爾已在其位于亞利桑那州錢德勒的工廠投資了超過10億美元,用于玻璃研發生產線,并開發了具有3個再分配層(RDL)和75μm玻璃通孔(TGV)的電子功能組裝多芯片封裝(MCP)測試車。
近日,有消息稱英特爾玻璃基板量產計劃提前至2026年。對此,記者聯系了英特爾相關負責人,并獲得回復稱:最近沒有更新的進展。
2024年1月,三星電機在 CES 2024 上宣布進軍半導體玻璃基板領域,并公布了 2024 年建立中試線、2025 年量產樣品、2026 年正式量產的路線圖。根據規劃,三星電機將在今年9月份之前將所需設備安裝到試驗線上,并在第四季度開始運營其試點生產線,比最初的計劃提前了一個季度。
國內封測頭部企業也在投資者平臺針對本公司在玻璃基板領域的布局作出了回應:
華天科技表示,公司有玻璃基板封裝研發布局。
通富微電表示,公司具有玻璃基板封裝相關技術儲備,具備使用TGV玻璃基板進行封裝的技術能力。謝鴻在接受《中國電子報》記者采訪時表示,通富微電玻璃基板技術大概在2026—2027年可以看到產品應用。

通富微電投資者平臺問答
晶方科技表示,公司專注于傳感器領域晶圓級封裝技術服務。TSV、TGV等是晶圓級封裝電互連的主要技術工藝手段。結合傳感器需求及自身工藝積累,公司具有多樣化的玻璃加工技術,包括制作微結構,光學結構,鍍膜,通孔,盲孔等,且公司自主開發的玻璃基板,在Fanout等封裝工藝上已有多年量產經驗。
頭部企業紛紛入局,似乎預示著芯片封裝企業真要的要迎來一場材料革命了?
此玻璃非彼玻璃
實際上,在芯片封裝領域,玻璃已經在發揮作用。例如為了實現對芯片的保護,產業界采取了GPP(玻璃鈍化)工藝技術,即將玻璃粉在晶圓表面燒結熔化后冷卻,產生與芯片融為一體的玻璃層,從而起到保護的作用。又如在晶圓封裝領域,玻璃基板可用于在晶圓減薄之后的載片環節,即作為芯片的支撐基板,用以幫助芯片順利完成后續加工環節,防止外部應力造成的碎片。上述案例,均已應用多年,即為業內所說的成熟工藝。
而近期被廣為討論的玻璃基板,與上述成熟工藝不同,指的是一種正在研發的新技術,即由玻璃替代當前的封裝基板(IC Package Substrate)材料——ABF和BT樹脂——IC載板最常用的兩種材料。
其中,BT樹脂載板在上世紀80年代實現初步應用,因BT樹脂具備耐熱性、抗濕性,低介電常數、低散失因素等多種優良特性,常用于穩定尺寸,防止熱脹冷縮改善設備良率,主要應用于存儲芯片、MEMS芯片、RF芯片與 LED芯片中。近兩三年成為在世界上迅速興起的高密度互連(HDI)的積層多層板(BUM)、封裝用基板的重要基板材料之一。
而另一種基板材料——ABF,在1999年之后逐漸成為半導體芯片行業的標配。該材料可用做線路較細、適合高腳數高傳輸的IC,但材料易受熱脹冷縮影響,可靠性較低,主要用于CPU、GPU、FPGA、ASIC 等高性能計算(HPC)芯片FC封裝。這兩類基板材料憑借各自優勢成為芯片封裝基板的標配。
近期,之所以封裝企業加碼玻璃基板,源自市場對異構芯片需求的強烈增長。玻璃基板在吸引到越來越多的關注的同時,正在向替代當前封裝基板材料的統治地位發起沖擊。隨著芯片處理需求的不斷增長,Chiplet等異構封裝需求愈來愈盛,這意味著單顆芯片的基板尺寸越來越大,而隨著芯片基板的增大,直接面臨的就是翹曲問題。
通富微電工程中心總經理謝鴻在接受《中國電子報》記者采訪時表示:“目前廣泛使用的有機基板和芯片的熱膨脹差別較大。導致封裝的翹曲問題。”
而玻璃即二氧化硅材料與硅基之間的熱膨脹系數更為接近,于是更易于避免芯片封裝中可能出現的翹曲問題。
這也正是英特爾此前在發布的公開信息中所說的“玻璃基板能使單個封裝中的芯片面積增加五成,從而塞進更多的Chiplet”最主要的原因。
易碎是核心痛點
英特爾作為玻璃基板技術的先鋒入局者,自十余年前已開始布局。而根據該公司自行公布的數據,預計將于2030年之前量產。作為Chiplet技術的主要倡議與貢獻者之一的英特爾,為何遲遲沒有實現玻璃基板技術量產?
其主要原因在于玻璃基板的易碎性帶來的潛在問題仍未徹底解決。首先,玻璃基板在生產過程中容易斷裂,不能像當前采用的有機基板一樣鉆孔;其次,采用玻璃基板封裝的芯片的動態表現也較差。為了解釋這一材料缺陷,謝鴻向記者舉了個例子:“比如我們用玻璃基板來封裝手機芯片,那么采用該芯片的手機即便是從1米左右的高度掉下來,都有可能導致芯片受損。”
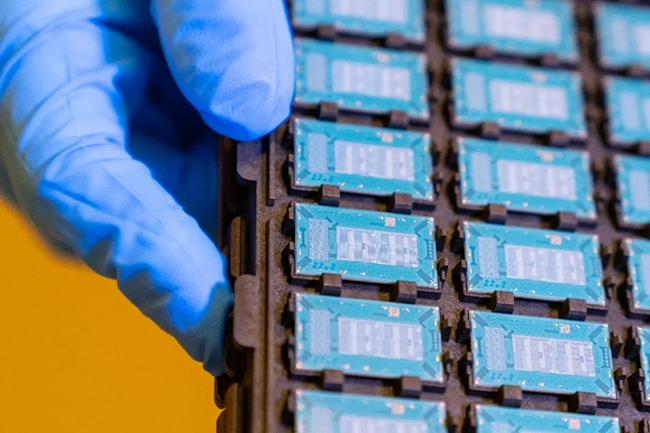
英特爾玻璃基板測試單元
Yole Group 半導體封裝技術與市場分析師比拉爾·哈希米表示,玻璃的易碎性給設備內部處理和加工帶來了問題,因此在制造過程中需要非常小心和精確。這對設備供應商和基板制造商來說是一個昂貴的挑戰。此外,玻璃基板給檢查和計量過程帶來了復雜性,需要專門的設備和技術來確保質量和可靠性。
如何解決玻璃易碎性的問題,成為困擾一眾布局玻璃基板技術的企業共同關心的話題。
對此,謝鴻介紹了當前業界解決這一問題的兩大解決方案:
其一,從材料本身著手,即對玻璃材料本身進行處理,通過添加微量元素的方式,改變玻璃的機械性能;或是通過改變玻璃的制造過程,改變材料性能。
其二,開發新的設備工藝。即通過借用其他材料或是更改產品生產工藝,實現保護的效果。
將率先替代大尺寸基板
關于芯片封裝用玻璃基板的量產時間,當前業內的普遍預估是在2026—2030年之間。集邦咨詢分析師許家源在接受《中國電子報》記者采訪時表示,玻璃基板技術預計在2027—2028年量產。
而關于玻璃基板率先采用的應用場景,業界普遍認為將在對計算性能要求較高的場景率先應用。
許家源認為,玻璃基板技術預計率先應用在服務器或筆記本的處理器芯片。
英特爾表示,玻璃基板最先將被用于其更能發揮優勢的地方,即需要更大尺寸封裝和更快計算速度的應用和工作負載,包括數據中心、AI、圖形計算等。
謝鴻表示,最先應用玻璃基板技術的場景,將是在60毫米以上的較大尺寸基板領域以及多芯片異構集成的產品中,此類產品多為高性能產品。
對于當前計算需求提升帶給先進封裝的要求,玻璃基板也將成為有力“小幫手”。一如當前先進封裝常常采用的2.5D、3D封裝的方法,將擴大封裝基板的使用面積。若采用當前市面上的傳統有機材料基板,更大的封裝基板面積意味著更大的翹曲概率,而玻璃基板將大大降低翹曲的可能性。
作者:姬曉婷 來源:中國電子報、電子信息產業網
本文為本網轉載,出于傳遞更多信息之目的,并不意味著贊同其觀點或證實其內容的真實性,如涉及侵權,請權利人與本站聯系,本站經核實后予以修改或刪除。


請完善以下信息,我們的顧問會在1個工作日內與您聯系,為您安排產品定制服務
評論